
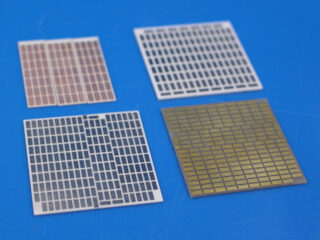
陶瓷通常被称为无机非金属材料。由此可见,人们直接将陶瓷置于金属的对立面。毕竟,两者的性能截然不同。但两者优势过于突出,很多时候需要将陶瓷与金属结合起来,各显其长,于是陶瓷金属化技术应运而生。
尤其随着5G时代的到来,半导体芯片功率不断提升,轻薄化、高集成化的发展趋势愈加明显,散热的重要性也日益凸显。这无疑对封装散热材料提出了更为严苛的要求。在电力电子元件封装结构中,封装基板作为连接上下层、保持内外电路连通的关键环节,兼具散热、机械支撑等功能。陶瓷作为一种新兴的电子散热封装材料,具有导热性好、绝缘性强、耐热性好、强度高、热膨胀系数与芯片匹配等诸多优势,是电力电子元件理想的封装散热材料。
用于电路的陶瓷首先必须进行金属化处理。在陶瓷表面需涂覆一层金属膜,使其导电,然后与金属引线或其他金属导电层焊接,使其连接成为一体。
陶瓷-金属封接工艺中最重要的一步是金属化,其质量影响最终的封接效果。
陶瓷与金属焊接的难点
1. 陶瓷的线膨胀系数较小,而金属的线膨胀系数较大,容易导致接头开裂。通常需要处理好金属中间层的热应力。
2. 陶瓷本身导热系数低,抗热震性差。焊接时,必须降低焊接温度并控制焊后冷却速度。
3. 大多数陶瓷的导电性较差,甚至不导电,难以采用电焊。
4. 由于陶瓷材料稳定的电子配位,金属与陶瓷之间的连接不易实现。需要对陶瓷进行金属化或使用活性钎料进行钎焊。
5. 由于陶瓷材料多为共价晶体,不易变形,常发生脆性断裂。目前多采用中间层降低焊接温度,并采用间接扩散法进行焊接。
6. 陶瓷与金属焊接的结构设计与普通焊接不同,通常分为平封结构、套筒结构、针封结构和双封结构。套筒结构效果最佳,此类接头结构的制作要求很高。
陶瓷金属化机理
陶瓷金属化机理较为复杂,涉及多种化学物理反应、物质的塑性流动以及颗粒重排。金属化层中的各种物质,例如氧化物和非金属氧化物,在不同的烧结阶段会发生不同的化学反应以及物质的扩散迁移。随着温度升高,各物质发生反应生成中间化合物,当达到共同熔点时,形成液相。液相玻璃相具有一定的粘度,同时产生塑性流动。随后,在毛细作用下,颗粒重新排列。在能量驱动下,原子或分子发生扩散迁移,晶粒长大,孔隙逐渐缩小直至消失,金属化层致密化。
陶瓷金属化工艺
1. 基体预处理。
2. 金属化浆料制备。
3. 涂覆与干燥。
4. 热处理。
陶瓷金属化的具体方法
1. 钼锰法
2. 活化钼锰法
3. 活性金属钎焊
4. 直接敷铜 (DBC)
5. 磁控溅射
陶瓷金属化的影响因素
1. 金属化配方
2. 金属化温度及保温时间
3. 金属化层微观结构
4. 其他因素
声明:此篇为INNOVACERA®原创文章,转载请标明出处链接:https://www.innovacera.com/zh-hans/news-zh-hans/what-technology-enables-ceramics-and-metals-to-achieve-a-strong-combination.html。




 发送询盘
发送询盘