Cómo elegir el sustrato cerámico adecuado para la gestión térmica de LED de alta potencia
En el contexto de la rápida popularización de la iluminación LED, la gestión térmica se ha convertido en un factor crucial que determina el rendimiento, la fiabilidad y la vida útil de los LED. A medida que la tecnología LED avanza hacia una mayor potencia, un mayor brillo y una mayor integración, la densidad de calor por unidad de área sigue aumentando. Una capacidad de disipación de calor insuficiente limitará directamente la mejora del rendimiento del dispositivo.
Cuando la temperatura de la unión es demasiado alta, los LED experimentan problemas como la deriva de la longitud de onda de la emisión de luz, la atenuación de la eficiencia lumínica, el envejecimiento acelerado del fósforo y una reducción significativa de la vida útil. Por lo tanto, cómo transferir de forma eficiente y estable el calor generado por los chips se ha convertido en un aspecto clave en el diseño de encapsulados LED de alta potencia.
En la práctica, el calor generado por los dispositivos electrónicos LED se disipa generalmente hacia el exterior a través del sustrato. El sustrato, como núcleo de la gestión térmica, puede absorber rápidamente el calor generado por el chip y lograr una distribución uniforme del calor. Posteriormente, disipa eficazmente el calor al ambiente a través del disipador térmico, garantizando el funcionamiento estable a largo plazo del LED.
La conductividad térmica, las características de resistencia térmica del sustrato, así como su compatibilidad con el proceso de encapsulado, determinan directamente el nivel general de gestión térmica del LED. Los sustratos cerámicos han demostrado un excelente rendimiento en estos aspectos y han sustituido gradualmente a los sustratos metálicos o compuestos tradicionales, convirtiéndose en la opción preferida para los LED de alta potencia.
Los sustratos cerámicos varían en rendimiento y coste, por lo que deben seleccionarse en función de la potencia del LED, los requisitos térmicos y las condiciones de aplicación.

Materiales comunes para sustratos cerámicos y sus características
Sustrato de alúmina (Al₂O₃)
El material de sustrato cerámico más utilizado actualmente. Presenta ventajas integrales como bajo costo, alta resistencia mecánica, tecnología madura y buena fiabilidad. Su conductividad térmica suele estar entre 20 y 30 W/m·K, lo cual es suficiente para cumplir con los requisitos de disipación de calor de los LED de potencia media y baja. Por lo tanto, es una opción muy rentable y práctica para iluminación general y aplicaciones donde el costo es un factor importante.
Sustrato de nitruro de aluminio (AlN)
El AlN ofrece una conductividad térmica de 170–230 W/m·K, muy superior a la de la alúmina. Su expansión térmica es similar a la de los chips de silicio, lo que reduce la tensión térmica y mejora la fiabilidad. Con una baja constante dieléctrica y un excelente aislamiento, el AlN es ideal para LED de alta potencia y alta densidad, así como para dispositivos de alta frecuencia.
Sustrato de alúmina reforzada con zirconia (ZTA)
El ZTA es una cerámica compuesta que se obtiene al añadir zirconia a la alúmina. Ofrece alta resistencia mecánica, excelente tenacidad a la fractura y buena fiabilidad. Su conductividad térmica es superior a la de la alúmina estándar, pero inferior a la del AlN. El ZTA es adecuado para aplicaciones LED que requieren alta resistencia mecánica y resistencia al choque térmico, manteniendo una disipación de calor eficaz a la vez que mejora la resistencia a las grietas y la estabilidad a largo plazo.
Sustrato de Nitruro de Silicio (Si₃N₄)
Los sustratos de Si₃N₄ ofrecen alta resistencia mecánica, excelente resistencia al choque térmico y buena conductividad térmica. Se mantienen estables ante grandes variaciones de temperatura y ciclos térmicos frecuentes, lo que garantiza su fiabilidad a largo plazo. A pesar de la mayor dificultad de procesamiento, el Si₃N₄ es la opción preferida para LED y aplicaciones industriales que exigen la máxima fiabilidad.
Factores clave para la selección de Sustratos cerámicos
– Conductividad térmica: Controla la temperatura de la unión y la eficiencia térmica.
– Coeficiente de expansión térmica (CTE): Reduce el estrés térmico para un funcionamiento fiable.
– Aislamiento dieléctrico: Garantiza la seguridad eléctrica y la estabilidad de las señales.
– Resistencia mecánica y procesabilidad: Adecuado para procesos de encapsulado y requisitos de uso a largo plazo.
– Coste y personalización: Cumple con los requisitos de diversos escenarios de aplicación y escalas de producción.
Sugerencias para la selección de sustratos para LED de diferentes potencias
1. LED de potencia media-baja (≤ 1 W)
La generación de calor es relativamente baja y los requisitos de disipación térmica son relativamente flexibles. El sustrato cerámico de alúmina (Al₂O₃) cumple con los requisitos de control de temperatura, se caracteriza por su bajo costo y tecnología consolidada, y es adecuado para iluminación general y aplicaciones donde el costo es un factor crítico.
2. LED de potencia media (1–3 W)
El aumento en la densidad de calor conlleva mayores exigencias de conductividad térmica y fiabilidad. La alúmina de alta pureza o el ZTA son sustratos adecuados.Los sustratos, al equilibrar el rendimiento de disipación de calor y la resistencia mecánica, mantienen una buena relación costo-rendimiento y son adecuados para aplicaciones de iluminación convencionales de potencia media.
3. LED de alta potencia (≥ 3 W)
El control de la temperatura es fundamental. Los sustratos cerámicos de nitruro de aluminio (AlN), con su alta conductividad térmica y excelente coeficiente de dilatación térmica, pueden reducir eficazmente la resistencia térmica del encapsulado y son la opción principal para LED de alta potencia.
4. Aplicaciones de alta densidad de potencia y alta fiabilidad
En condiciones de alta temperatura, alta tensión o ciclos térmicos frecuentes, los sustratos de nitruro de silicio (Si₃N₄), con su excelente resistencia mecánica y resistencia al choque térmico, son adecuados para aplicaciones con requisitos de fiabilidad extremadamente altos.
En Innovacera, ofrecemos una variedad de materiales de sustrato cerámico y soluciones de tamaño personalizadas para satisfacer los requisitos de gestión térmica de los LED de diferentes niveles de potencia.







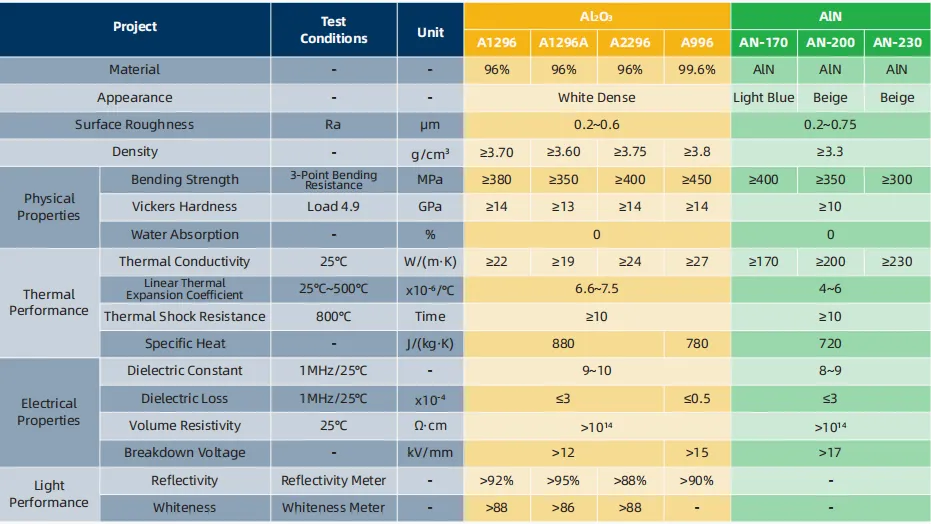


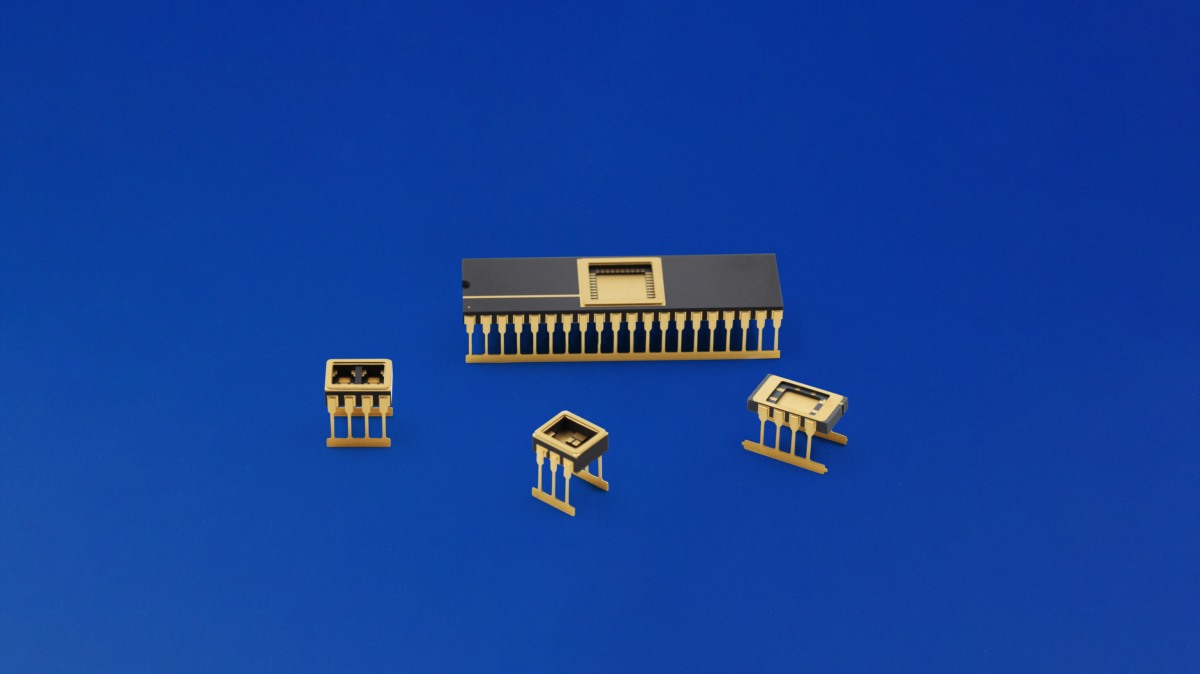




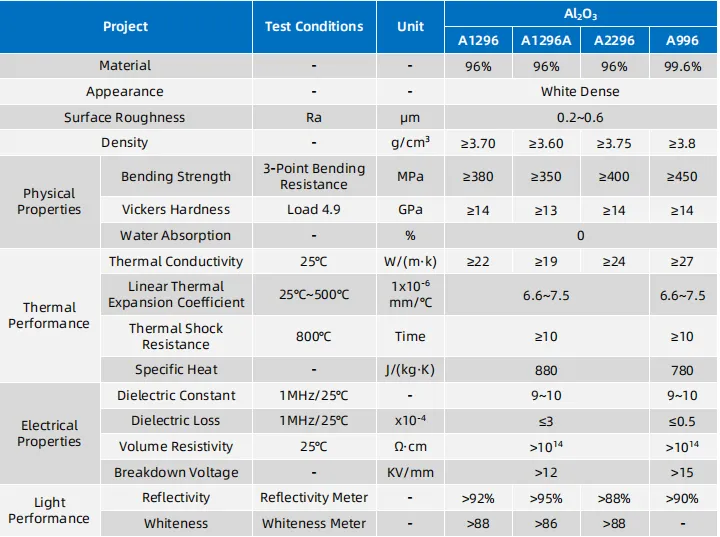

 enquiry
enquiry