TCV(セラミックビア貫通)相互接続技術は、高密度3次元パッケージングの革新的なアプローチです。従来の セラミック基板のメタライゼーション 方式では、穴の中に液体が残留したり、接着力が弱かったり、銅の充填が不完全だったりするなどの課題に直面することがよくあります。しかし、TCV技術では、セラミックビアに銅ペーストを充填する方法を採用しており、プロセスが簡単で、充填が完全で、接着力が強く、コストが低いという利点があります。
当社は、マイクロナノ複合材料からなる焼結銅ペーストを採用し、優れた導電性と信頼性を実現しています。高温バインダーと特殊フィラーを配合することで、銅ビアとインターフェースの熱膨張係数をさらに調整し、信頼性の高い銅ビア接続を実現します
TCVプロセスフローチャート
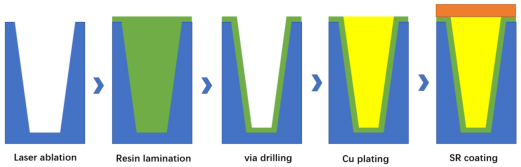
プロセス特性:
– 幅広い深さ対直径比に対応し、ペーストの優れた流動性により、ホール壁への完全な密着を実現します。
– ドライプロセスのため、銅めっき時の薬品残留がありません。
– 印刷のみですべてのホールを完全に充填できるため、高いプロセス効率を実現します。
– 熱膨張係数を調整できるため、高い信頼性を実現します。
– 高効率、高品質、低コストの真空充填プロセスを実現します。
– 純銅に近い電気抵抗率で、大電流を効率的に伝導します。
– 低熱膨張係数と界面層により、高い信頼性を実現したスルーホール銅です。
プロセスの利点:
1. 誘電率が小さく、優れた高周波特性により、信号遅延時間を短縮します。
2. 熱膨張係数はシリコンに近いため、無機基板材料は一般的に有機基板材料よりも低いです。
3. 耐熱性に優れているため、無機基板材料は有機基板材料よりもガラス転移温度が高いため、熱衝撃やサイクル試験による損傷を受けにくくなります。
4. 熱伝導率が高く、高密度実装時に発生する熱を効率的に放散できます。
5. 機械的強度が高く、寸法安定性に優れているため、高い部品実装精度を確保できます。
6. 化学的安定性が高く、加工時の酸、アルカリ、有機溶剤による腐食に強く、変色、膨潤などの特性変化がありません。
7. 優れた絶縁性能により、高い信頼性を確保します。
処理能力:
| 基板 | 酸化アルミナ | 窒化アルミナ |
| 熱膨張係数 | 6.8 ppm/K | 4.7 ppm/K |
| 熱伝導率 | 23 W/m·K | 170 W/m·K |
| 寸法 | <182 x 182 mm | <120 x 120 mm |
| 厚み | 0.25 – 1 mm | 0.15 – 0.63 mm |
| 穴径 | >60 μm | >60 μm |
| 深度対直径比 | <10:1 | <10:1 |
| 穴の間隔 | >0.1 mm | >0.1 mm |
応用分野:
– 高出力電力エレクトロニクスモジュール、高周波スイッチング電源用太陽電池パネル部品、ソリッドステートリレー。
– 車載エレクトロニクス、レーザー、CMOSイメージセンサー。
– 高出力LED照明製品。
– 通信アンテナ、自動車用点火システム。
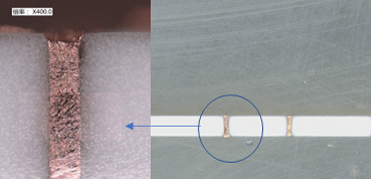
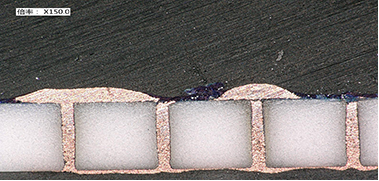
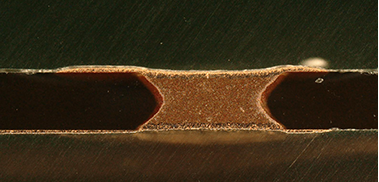
上記の材料にご興味をお持ちでしたら、お気軽に+86-592 5589730までお電話いただくか、sales@innovacera.comまでメールでお問い合わせください。詳しいお話やご連絡をお待ちしております。
声明:これはINNOVACERA®のオリジナル記事です。転載する際は、出典リンクを明記してください:https://www.innovacera.com/ja/news-ja/an-introduction-to-through-ceramic-via-tcv-interconnection-technology.html。




 お問い合わせ
お問い合わせ