陶瓷通孔(TCV)互连技术是高密度三维封装的一种创新方法。传统的陶瓷基板金属化方案经常遇到孔内液体残留、附着力差、铜填充不完整等问题。而TCV技术采用铜浆填充陶瓷通孔的方法,工艺简单、填充完整、附着力强、成本低廉。
Innovacera采用微纳复合材料组成的烧结铜浆,具有良好的导电性和可靠性。通过加入高温粘结剂和特殊填料,可以进一步调节铜通孔和界面的热膨胀系数,实现高可靠性的铜通孔连接。
TCV工艺流程图
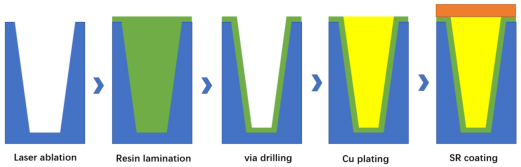
工艺特点:
– 深径比范围广,膏体流动性好,可完全粘附在孔壁上。
– 干法工艺,消除镀铜化学残留。
– 工艺效率高,所有孔仅通过印刷即可完全填充。
– 可靠性高,热膨胀系数可调。
– 真空填充工艺效率高、质量高、成本低。
– 实现大电流的有效传导,电阻率接近纯铜。
– 通过低热膨胀系数的通孔铜和界面层实现高可靠性。
工艺优势:
1.介电常数小,高频特性优异,减少信号延迟时间。
2.热膨胀系数更接近硅,无机基板材料一般比有机基板材料热膨胀系数低。
3.耐热性强,无机基板材料的玻璃化转变温度高于有机基板材料,在热冲击和循环过程中不易损坏。
4.热导率高,可高效散发高密度封装产生的热量。
5.机械强度高,尺寸稳定性好,确保元件安装精度高。
6.化学稳定性强,加工过程中可抵抗酸、碱、有机溶剂的腐蚀,不会发生变色、膨胀等特性变化。
7.绝缘性能优异,确保高可靠性。
处理能力:
| 基材 | 氧化铝 | 氮化铝 |
| 热膨胀系数 | 6.8 ppm/K | 4.7 ppm/K |
| 热导率 | 23 W/m·K | 170 W/m·K |
| 尺寸 | <182 x 182 mm | <120 x 120 mm |
| 厚度 | 0.25 – 1 mm | 0.15 – 0.63 mm |
| 孔径 | >60 μm | >60 μm |
| 深度与直径之比 | <10:1 | <10:1 |
| 孔间距 | >0.1 mm | >0.1 mm |
应用:
– 大功率电力电子模块、高频开关电源太阳能电池板组件、固态继电器。
– 汽车电子、激光器、CMOS图像传感器。
– 大功率LED照明产品。
– 通信天线、汽车点火系统。
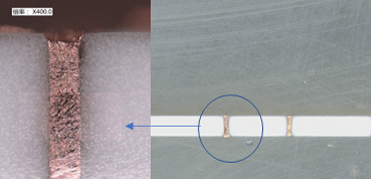
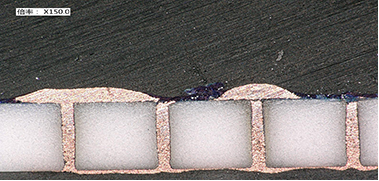
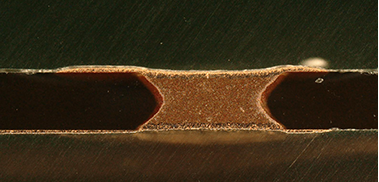
如果您对上述材料技术感兴趣,欢迎致电 +86-592 5589730 或发送电子邮件至 sales@innovacera.com 与我们联系,进行进一步讨论和沟通。我们期待您的来电!
声明:此篇为INNOVACERA®原创文章,转载请标明出处链接:https://www.innovacera.com/zh-hans/news-zh-hans/an-introduction-to-through-ceramic-via-tcv-interconnection-technology.html。




 发送询盘
发送询盘