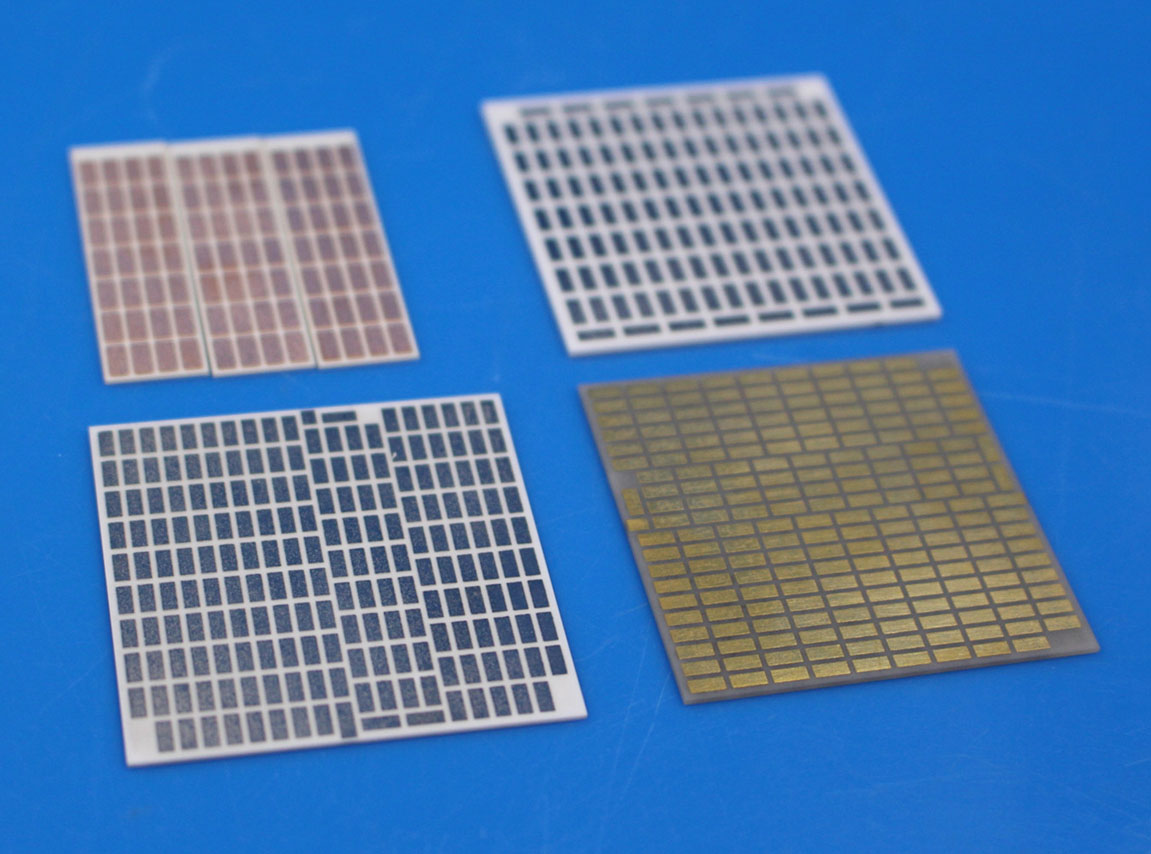
金属化陶瓷基板是一种电路板,其热膨胀系数接近半导体,耐热性高,适用于发热量大的产品(高亮度LED、太阳能),其优异的耐候性更适合户外恶劣环境,因其具有无铅、无毒、化学稳定性好等特点,不会对环保造成危害,因此越来越被大众广泛接受。
由于工艺不同,陶瓷基板主要分为DBC(直接覆铜)、DPC(直接镀铜)、AMB(活性金属钎焊)、厚膜等。
我们将逐一介绍这些工艺,并介绍每种工艺的优缺点。
由陶瓷基板、粘结层、导电层组成,是指在高温下将铜箔直接粘结到氧化铝或氮化铝陶瓷基板表面的特殊工艺。
优点:
- 铜层厚;
- 加工速度快;
- 价格便宜;
- 可做多层;
- 适合大面积使用;
- 热导率高;
- 附着强度高;
- 软钎焊性好;
- 电绝缘性好
缺点:
- 不能过孔;
- 精度差;
- 平整度(表面粗糙度)低;
- 适合产品中大间距的器件,在精密场合无法做到。
DPC(直接镀铜)
主要通过蒸发、磁控溅射等表面沉积制程是在基板表面进行金属化,先在真空溅射下镀上钛金属,然后是铜粒子,镀上一定厚度,再用普通PCB工艺完成线路制作,然后再以电镀/化学镀的方式增加线路厚度,DPC的制备方式包含真空镀膜、湿法沉积、曝光显影、蚀刻等工序。
其优点有:
- 在外形加工方面,DPC陶瓷板需要激光切割,传统钻铣机、冲床无法精确加工,因此合力和线宽也更细;
- 金属结晶性能好;
- 平整度好;
- 线条不易脱落;
- 线条位置更精准,线条间距更小,可靠稳定,可过孔等优点;
其缺点有:
只能制作薄板(厚度<300μm),成本高,产值受限,导致经常出现出货时间不能按时的情况;
它是利用钎料中的少量活性元素Ti、Zr与陶瓷发生反应,形成可被液态钎料润湿的反应层,从而实现陶瓷与金属的结合。
其优点在于:
该结合是通过陶瓷与活性金属焊膏在高温下发生化学反应而实现的,因此其结合强度较高,可靠性较好。
其缺点在于:
AMB工艺的可靠性很大程度上取决于活性钎料的成分、钎焊工艺、钎焊层结构等诸多关键因素。
厚膜技术是直接在陶瓷基片上印刷图形,然后直接烧结的工艺。
优点:
- 与陶瓷的结合力比DPC工艺大很多;
- 是直接印刷图形,没有蚀刻、镀铜工序,成本会低一些;
- 是一次性成型,平整度比DPC更光滑。
缺点:
厚膜工艺因为是印刷,所以一般不会太厚,由于产品要求不同,材料不同对膜的导电性也有一定的影响。
所以很难说哪种工艺最好,要看客户的应用和使用情况,客户可以根据自己的情况选择每一种工艺他们的要求。
如果您有更多兴趣,请随时联系我们。


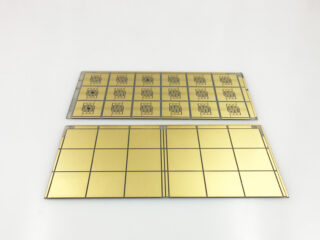

 发送询盘
发送询盘