集成电路用CDIP封装
Innovacera提供全面的陶瓷封装产品,包括CDIP、CFP和CQFP等九种类型。这些陶瓷封装广泛应用于集成电路、光通信、半导体、激光器封装和光电器件等领域。主要封装尺寸为中小尺寸,引脚数从8到44不等,可满足大多数设计需求。
氧化铝陶瓷是成本敏感型应用的理想选择,而氮化铝则适用于高功率和热敏感型设计。陶瓷双列直插式封装 (CDIP) 可提供多种引脚数,以适应不同的电路布局。

陶瓷封装类型
– 陶瓷双列直插式封装 (CDIP)
– 陶瓷扁平封装 (CFP)
– 陶瓷四方扁平无引脚封装 (CQFN)
– 陶瓷引脚网格阵列封装 (CPGA)
– 陶瓷无引脚芯片载体封装 (CLCC)
– 陶瓷四方扁平封装 (CQFP)
– 表面贴装器件 (SMD)
– ROSA 陶瓷封装
– TOSA 陶瓷封装
材料特性:92%氧化铝与93%氧化铝
系数热膨胀系数40–400°C×10⁻⁶/°C6.77.0
| 特性 | 测试条件 | 单位 | 92%氧化铝(黑色) | 93%氧化铝(白色) |
| Al₂O₃内容 | – | % | 92 | 93 |
| 密度 | 25°C | g/cm³ | 3.7 | 3.65 |
| 热导率 | 25°C | W/(m·K) | 20 | 18 |
| 40–800°C | ×10⁻⁶/°C | 6.9 | 7.2 | |
| 体积电阻率 | 20°C | Ω·cm | 10¹⁴ | 10¹⁴ |
| 300°C | Ω·cm | 10¹⁰ | 10¹⁰ | |
| 500°C | Ω·cm | 10⁸ | 10⁹ | |
| 介电常数 | 1 MHz | – | 10 | 9 |
| 介电损耗 | 1 MHz | ×10⁻⁴ | 4 | 4 |
| 弯曲强度 | 0.5 mm/min | MPa | 400 |
随着电动汽车、半导体技术和高频通信的蓬勃发展,全球陶瓷封装市场也随之增长。推动这一增长的关键创新包括:高导热基板(氮化铝,AlN 和氧化铝,Al₂O₃)、多层陶瓷封装 (MLC/MLP) 以及先进的气密封装技术。
氮化铝基板的导热系数高达 170 至 200 W/m²,且具有极佳的热膨胀系数 (CTE) 匹配度,这些特性显著提升了功率模块的可靠性和性能。另一方面,多层陶瓷封装能够降低射频信号损耗,并实现更高的集成密度,使其成为 5G/6G 前端模块、各类集成电路 (IC) 和微机电系统 (MEMS) 传感器的理想之选。
气密封装确保了长期运行的稳定性。对于半导体制造、测试设备以及对性能稳定性要求极高的光电应用而言,气密封装至关重要。
声明:此篇为INNOVACERA®原创文章,转载请标明出处链接:https://www.innovacera.com/zh-hans/news-zh-hans/cdip-packages-and-innovaceras-ceramic-packaging-solutions.html。

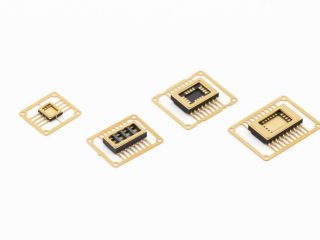


 发送询盘
发送询盘